「ゲーム機が品薄なのは味の素社のせいだ」ネットでこんなウワサが流れたまんざらでもない理由
プレジデントオンライン / 2021年10月22日 10時15分
■パッケージ基板には座布団のような役割がある
世界的な半導体不足の影響で、パソコンやゲーム機、自動車、家電など、幅広い製品が品薄状態となっている。その原因は複合的で、ネットワーク機器など元々あった需要の増大に加えて、新型コロナウイルス発生による需要予測の誤り(各メーカーが注文・生産を抑制したが、予想に反して需要が回復)やリモートワークによるPC需要の高まり、さらには米中対立も要因に挙げられている。
そんな中、今年初め、ネット上である噂が立った。最新ゲーム機「PlayStation5」や「Xbox Series X/S」が品薄で手に入らないのは、「味の素社のせい」というのである。一体どういうことか?
味の素社といえば、誰もが知るうま味調味料「味の素」をはじめとした調味料、冷凍食品など加工食品を扱う食品メーカーである。そのグループ企業、味の素ファインテクノ社は、各種半導体パッケージに欠かせない層間絶縁材「味の素ビルドアップフィルム(以下、ABF)」を生産している。パソコン用CPUでは、ほぼ100%のシェアを占めるとされるこのABFの生産が追いつかず、新型ゲーム機のボトルネックになっている説につながったというわけだ。

ABFの話をする前に、半導体パッケージ基板の基礎知識について説明する。
パソコンのCPUを例にするが、CPUのICチップはマザーボードに直接接続されているわけではない。上の写真のように、ICチップはパッケージ基板と呼ばれる小さな基板の上に載せられ、ひとつのパッケージとなっている。マザーボードを床、ICチップを人間とするなら、パッケージ基板は座布団のようなものだとイメージしてもらうと分かりやすいだろうか。
パッケージ基板は、ICチップを保護しながらマザーボードに電気的に接続する役割を担っている。座布団のクッション性のおかげで、人間の脚が床の硬さから守られつつしっかりと座れるようになるのに似ている。ナノメートルサイズのICチップの電子回路をミリメートルサイズの電子部品に接続するため、パッケージ基板は微細な電子回路を何層にも積み上げて作られる。その製造において絶縁材のABFが必要とされるのである。
■ABFは調味料の副生成物の研究から生まれた
食品メーカーである味の素グループが、なぜこれほど重要な部材を供給できるのか。ABFの開発には、調味料の原料となるアミノ酸で培ったノウハウが応用されており、その研究は50年以上前にさかのぼる。

「味の素」の主成分は、グルタミン酸ナトリウムである。うま味のもとであるグルタミン酸は、現在さとうきび等を発酵させることで生産している。創業当初からしばらくは昆布などからの抽出法を採用していたが、1960年代には化学合成する方法で生産されていた。その化学合成の過程で生成させる中間体から、エポキシ樹脂に使用できる硬化剤が開発された。
またグルタミン酸の中和工程で使われる苛性ソーダは、食塩水の電気分解で生成されるが、副生成物の塩素の有効活用として、難燃剤として使用できる塩素化パラフィンが開発された。
さらに、核酸系調味料であるイノシン酸やグアニル酸は、その原料であるイノシンやグアノシンをリン酸化させて作るが、そのリン酸化で使用されるオキシ塩化リンを利用して難燃剤として使える材料、リン酸エステルが生成される。
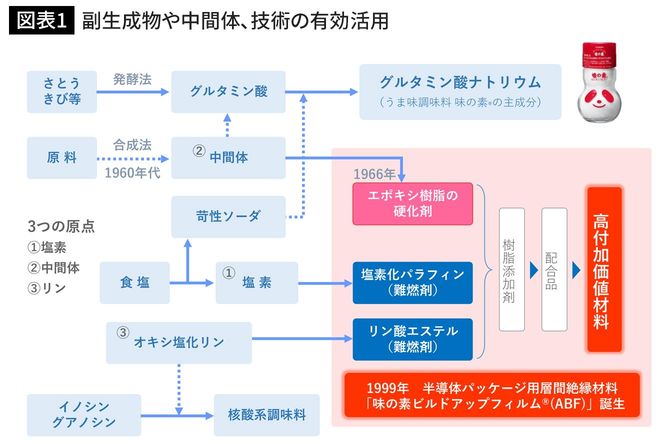
以上、エポキシ樹脂、塩素化パラフィン、リン酸エステルの3つから、樹脂系添加剤やその配合品を開発してきた。そして、ABFのような高付加価値材料の開発につながっている。
■後発にも関わらず、業界初のフィルム材料を開発
味の素ファインテクノ社が目を付けたのは、1990年代後半に急拡大したパソコン市場だった。当時、ICチップは従来のセラミックからプラスチックパッケージへと大きく転換するタイミングで、軽さと薄さ、安価を実現したことでパソコンの普及を加速させていた。
同時に、パッケージ基板の製造プロセスにもイノベーションが求められていた。従来は絶縁材料として液状のインキが使用されていたが、基板にインキを塗布し乾燥を繰り返すため、工程数が多い、平滑性が悪い、配線間に気泡が残りやすい、ゴミが付着しやすいといった課題があった。これらの課題は、絶縁体を液体(インキ)から固体(フィルム)にすることで解決できると予想されていたものの、技術的に難易度が高く、素材メーカーは手をこまねいていた。
そこで、味の素ファインテクノ社は開発に着手し、後発であったにも関わらず、製品化に成功する。食品メーカーのイメージから営業に苦労しつつも、その高い絶縁性、密着性、接続信頼性が評価され、業界初のフィルム材料として、99年に大手半導体メーカーに採用された。
以降、PCの普及にともないABFは生産量を拡大し続ける。現在では、CPU、GPU等のパソコン用半導体パッケージ以外に、ゲーム機、サーバー・通信ネットワーク、車載用途など広く採用されている。

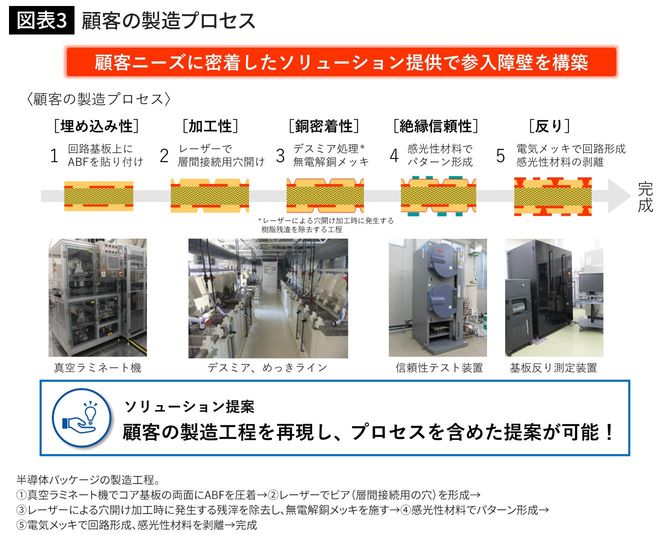
■製造プロセスを含めた提案力やバリューチェーンに強み
ABFはただ素材として供給されるのではない。味の素ファインテクノ社は、半導体パッケージメーカーや半導体メーカーと密にコミュニケーションをとっており、顧客の製造プロセスを含めた提案、細やかな技術サポートを行っている。さらに、原材料メーカーから、基板製造プロセスに関わる薬液メーカー、装置メーカーといった、直接の顧客以外のバリューチェーンすべての会社と連携しており、競合他社にとっては参入障壁となっている。
半導体パッケージの鍵としてデファクトスタンダードとなったABFだが、今後予想されるパッケージ基板のトレンド、微細配線化、大型化、高多層化、高速開発サイクルにも対応していく。そのために、最新の機器設備や実験スペース、顧客とのコラボレーション促進を目的とした新R&D(研究開発)棟の建設も計画している(2022年6月に完成予定)。
5G到来に伴うサーバー・通信ネットワークや車載用途、人工知能(AI)の普及により、今後も世界の半導体市場は拡大を続け、今後10年で2倍以上成長するとの予測もある。ABFも多用途展開により、2024年の出荷量を2019年比で2倍以上になると見込んでいる。
ちなみに冒頭で紹介した噂、「味の素社(ABF)がゲーム機生産のボトルネックになっている」だが、同社は「顧客需要には応えられている」と明確に否定する。
ABFは直接コンシューマーの目に触れることのない部材だが、料理に使われる調味料のように欠かせない存在になっている。アミノ酸における研究開発を、食品分野にこだわることなく、大きなトレンドになりつつあった半導体領域に挑戦したからこその成果である。
----------
ライター
コラムニスト。ITや家電を中心にモノとビジネスのあり方をウォッチし続け、『DIME』(小学館)『日経トレンディネット』(日経BP)等の雑誌やWebメディアなどで活躍する。「ドヤ家電(自慢したくなる家電)」の名付け親。エンタメ×テックのコンサルティングも行う。
----------
(ライター 小口 覺)
外部リンク
この記事に関連するニュース
-
AI半導体向け材料の生産能力を拡大
PR TIMES / 2024年3月29日 12時45分
-
まだ間に合う!日本の半導体関連・出遅れ株5選
トウシル / 2024年3月27日 20時6分
-
TSMCとSynopsysがNVIDIA cuLithoを用いた半導体生産を開始
マイナビニュース / 2024年3月26日 16時35分
-
吉川明日論の半導体放談 第296回 AI半導体を制するのは誰か?
マイナビニュース / 2024年3月25日 15時27分
-
TSMC と Synopsys が画期的な NVIDIA コンピュテーショナル リソグラフィ プラットフォームでの生産を開始
PR TIMES / 2024年3月21日 11時15分
ランキング
-
1那須・遺体遺棄 県警が黒色セダンを押収 2人を運んだ車か
毎日新聞 / 2024年4月19日 22時33分
-
2男性「出頭前に3人で相談」=発見前夜、防カメに宝島さん―那須2遺体・栃木県警
時事通信 / 2024年4月19日 23時6分
-
3機能性表示食品見直しへ消費者庁が初会合 報告ルール整備など焦点に
毎日新聞 / 2024年4月19日 19時48分
-
4小林製薬「紅麹」成分含むサプリメント 「プベルル酸」以外の本来は入っていない複数の物質検出 国立医薬品食品衛生研究所
TBS NEWS DIG Powered by JNN / 2024年4月19日 17時47分
-
5規正法改正、岸田首相「自民案示す」=来週策定、公明要求で方針転換
時事通信 / 2024年4月19日 19時43分
記事ミッション中・・・
記事にリアクションする
![]()
記事ミッション中・・・
記事にリアクションする

エラーが発生しました
ページを再読み込みして
ください










